在半导体封装这一精密制造领域,材料的选择直接决定着芯片的可靠性、性能与寿命。随着集成电路制程不断逼近物理极限,封装材料需要同时应对高温、高频、高湿等多重挑战。
聚酰亚胺凭借其近乎完美的综合性能,成为高端半导体封装的首选材料,被誉为行业的“黄金铠甲”。

摄于25橡塑展 长春高琦展台
本文将从聚酰亚胺(PI)及其衍生材料光敏性聚酰亚胺(PSPI)的结构、性能和封装应用三方面进行叙述。如有建议,欢迎留言或加入艾邦半导体材料交流群讨论。

1.聚酰亚胺薄膜
分子结构:卓越性能的源头
Part.1

聚酰亚胺(PI)是分子中含有酰亚胺基团(—R—CO—NH—CO—R--)的一类高性能工程塑料,以其出色的热稳定性、机械性能、化学耐性以及电绝缘特性而著称,被誉为“21世纪最有希望的高分子材料”,位列高性能聚合物材料金字塔的顶端。

2.刚柔并济:由于其分子排列紧密,自由体积低至0.08nm³,使其兼具高强度(拉伸强度≥200MPa)与优异柔韧性(弯折半径可低至1mm)。
3.优良的电绝缘性能良:PI薄膜的介电常数(3.2@1MHz)和介电损耗极低,为高频信号提供了近乎无损的传输通道。
对比传统PET薄膜,其体积电阻率(≥10¹⁶Ω・cm)提升了一个数量级,即使在200℃高温下,绝缘性能仍能保持95%以上。

2.光敏性聚酰亚胺
分子结构:卓越性能的源头
Part.1

光敏性聚酰亚胺(PSPI)是一种先进的高分子聚合物材料。从化学结构上看,它在聚酰亚胺(PI)的分子链上引入了光敏基团(如环氧基、双键、偶氮化合物等)或通过配方添加光敏成分。

多光敏基团聚酰胺酯的结构
光敏性聚酰亚胺(Photosensitive Polyimide, PSPI)作为具有卓越物理性能的光刻胶材料,广泛应用于人工智能(AI)硬件、5G/6G通信、柔性显示和先进封装等领域。
PSPI不仅拥有传统PI材料的热稳定性、机械强度和电绝缘性,还拥有在光照下进行精确图形化的光刻性能。
当受到光照时,其分子结构会发生交联或分解等化学变化,导致其在特定显影液中的溶解度发生改变,从而能够像光刻胶一样被直接、精确地加工成微米级的复杂图形。
传统PI图形化工艺需经过涂覆、光刻胶掩模、刻蚀、去胶四步流程,而光敏聚酰亚胺(PSPI)直接通过涂覆-曝光-显影-固化一步成型,省去掩模和刻蚀步骤,大幅简化工艺、降低成本并提升良率。

传统PI图形化工艺

PSPI一步成型
从根本上简化了微电子制造中至关重要的介电层和保护层加工流程,实现了显著的降本增效,并为电子器件的持续微型化、三维集成化和功能多样化开辟了全新的可能性。
市场及应用
Part.2

1.对于传统PI材料:全球半导体巨头已深度依赖PI薄膜实现技术突破。
英特尔在10nm以下制程中采用PI薄膜作为应力缓冲层,将芯片良率从80%提升至90%以上;台积电则通过PI基再布线层,将2.5D封装互连带宽提升30%。
2.对于先进PSPI材料,其将成为成为2.5D/3D先进封装的核心材料,成为延续芯片性能提升的关键路径,主要应用于两大关键环节。
(1)、缓冲涂层/钝化层
作为芯片表面的"防护盾",PSPI薄膜可缓冲封装应力(防芯片开裂),同时阻隔湿气、化学腐蚀和α射线,显著提升芯片可靠性。
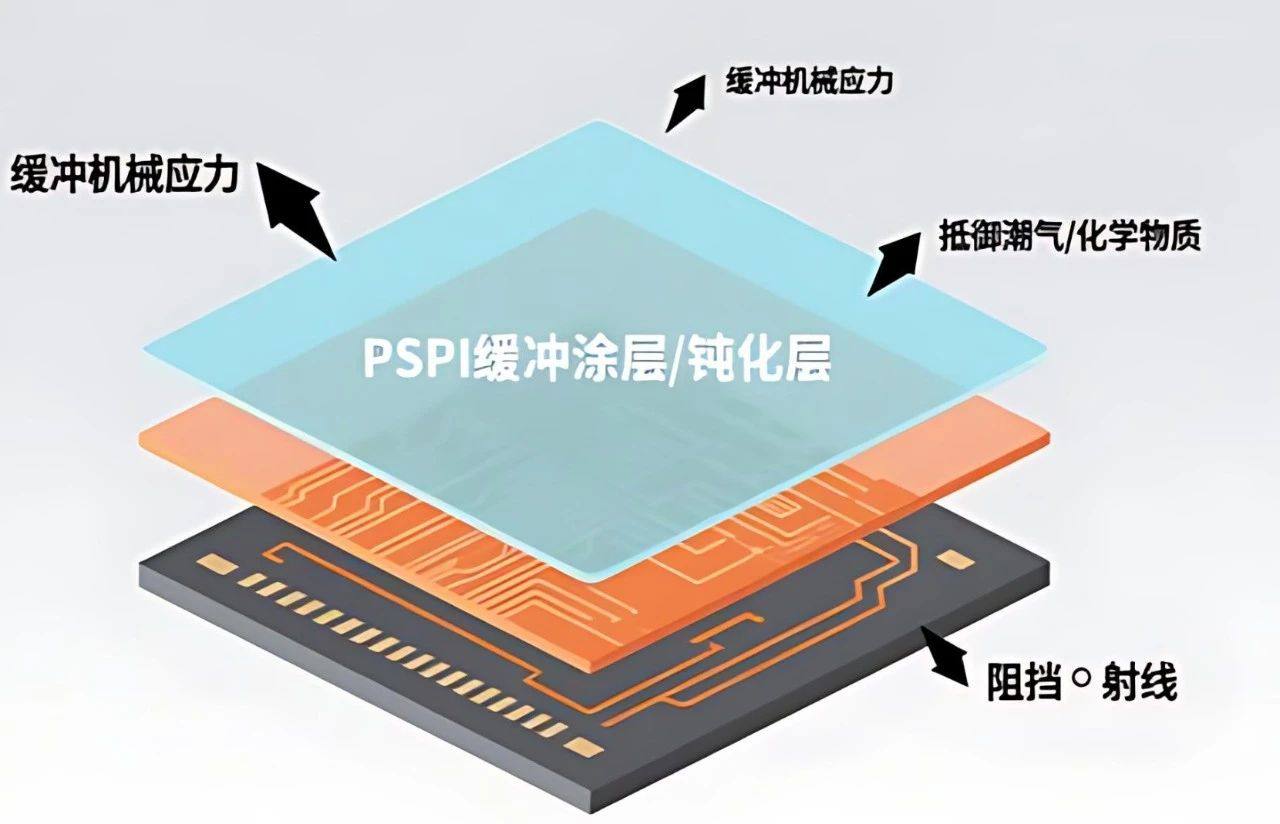
(2)、再布线层(RDL)
在Fan-Out等封装技术中,PSPI充当金属线路的绝缘介质,通过低介电常数(Low-k)特性保障高速信号传输,实现芯片I/O焊盘的高密度重分布,是异构集成得以实现的关键材料。
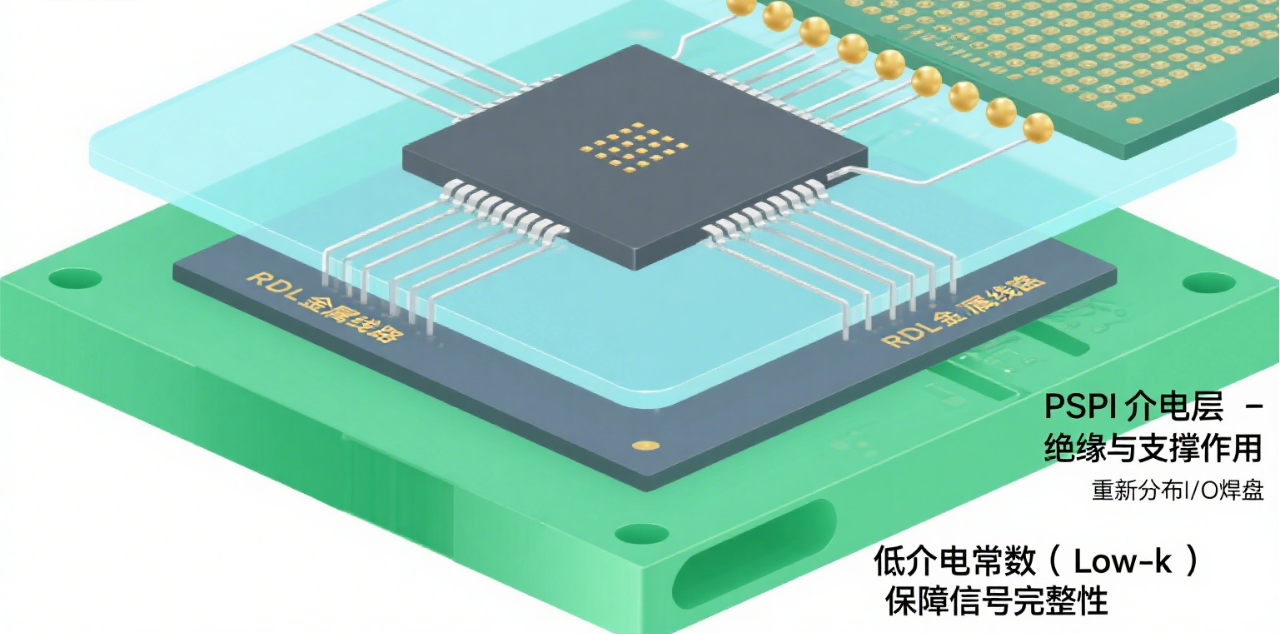
全球PSPI市场规模2024年约5.5亿美元,受益于AI芯片、先进封装和柔性电子等需求爆发,预计将以25%以上的年增速持续扩张,2030年有望突破25亿美元。
主要增长动力来自四大领域:
1)AI芯片推动的CoWoS等先进封装技术;
2)可折叠设备OLED屏幕应用;
3)5G/6G通信的低介电需求;
4)汽车电子和物联网的耐高温要求。

PSPI市场呈现"一超多强"格局:从产品看,负性PSPI占60%主导封装应用,正性PSPI占40%主攻显示面板高精度需求;

从应用看,显示面板(45%)、芯片封装(35%)和PCB(20%)构成三大支柱,

地域分布高度集中,亚太地区独占65%份额,尤以中国台湾(代工龙头)、中国大陆(增速第一)、韩国(面板巨头)和日本(技术源头)为四大核心市场,欧美合计占30%主要服务于高端领域。
国际领先PSPI企业
|
公司 |
核心优势与产品 |
最新动态与战略 |
|
东丽 (Toray) |
行业领导者,Photoneece®系列覆盖全类型PSPI,产品线最全面 |
推出厚膜加工STF-2000系列,开发环保型产品,保持技术领先 |
|
富士胶片 |
Durimide™和LTC™系列以低温固化、高可靠性著称,专注先进封装领域 |
重点布局RDL和缓冲层应用,应对封装热预算挑战 |
|
旭化成 |
Pimel™系列是台积电CoWoS等AI芯片封装的关键材料 |
2025年因AI需求激增暂停部分供应,宣布扩产并获台积电"卓越表现奖" |
|
杜邦/HD Micro |
聚酰亚胺技术开创者,拥有基础专利,合资企业专注PI前驱体和PBO等高可靠性材料 |
整合杜邦与日立化成技术优势,强化微电子领域布局 |
未来展望
Part.3

随着AI、5G/6G通信、自动驾驶等技术的快速发展,半导体封装对材料性能的要求将愈发严苛。聚酰亚胺(PI)及光敏聚酰亚胺(PSPI)作为关键封装材料,未来将在以下方向实现突破:
超薄化与高性能化:12μm以下的超薄PI薄膜技术将成为竞争焦点,纳米复合改性有望将导热率提升至200W/(m·K)以上,满足高功率芯片的散热需求。
智能化功能拓展:自修复、自监测等智能PI材料将提升芯片的长期可靠性,尤其在汽车电子和航天领域具有巨大潜力。
绿色制造与循环经济:环保型PSPI及回收技术的突破将推动行业可持续发展,减少对进口材料的依赖。
3D集成与先进封装:随着Chiplet和3D堆叠技术的普及,PSPI在RDL(再布线层)和TSV(硅通孔)中的应用将进一步扩大,成为异构集成的核心材料。
未来,聚酰亚胺材料不仅将支撑半导体产业的技术迭代,更可能催生新的封装范式,推动电子设备向更轻薄、更高性能、更可靠的方向发展。
国内企业若能突破关键技术瓶颈,将有望在这一高附加值领域实现自主可控,重塑全球产业链格局。
塑料在半导体制程中发挥重要作用,抗静电塑料、PP、ABS、PC、PPS、PEI,氟材料、PEEK、PI、PAI等塑料被广泛应用半导体制程中,如载具,治具,洁净室,管道,输送系统,化学品存放等。


